半導體封裝界,為咗追上「超越摩爾定律」(More Than Moore)嘅潮流,2.5D同3D封裝已經成為增長最快嘅先進封裝技術之一。
其實,可以同2.5D同3D封裝相提並論嘅技術仲有:異構集成、扇出型、FOWLP、FOPLP、矽通孔、玻璃封裝、封裝天線、共封裝光學器件、RDL等等。呢啲技術正正喺為人工智能、高性能計算(HPC)、數據中心、自動駕駛車、5G同消費電子等領域帶嚟更大嘅性能提升。
一、半導體封裝嘅演進
2.5D同3D封裝技術融合咗好多唔同嘅封裝工藝。喺2.5D封裝裏面,根據中介層材料嘅唔同,分做矽基、有機基同玻璃基中介層;而喺3D封裝裏面,微泵技術嘅發展進一步實現咗更細嘅間距尺寸。另外,透過採用混合鍵合技術(例如直接連接Cu-Cu)可以實現個位數嘅間距尺寸,標誌住呢個領域嘅一次重大進步。
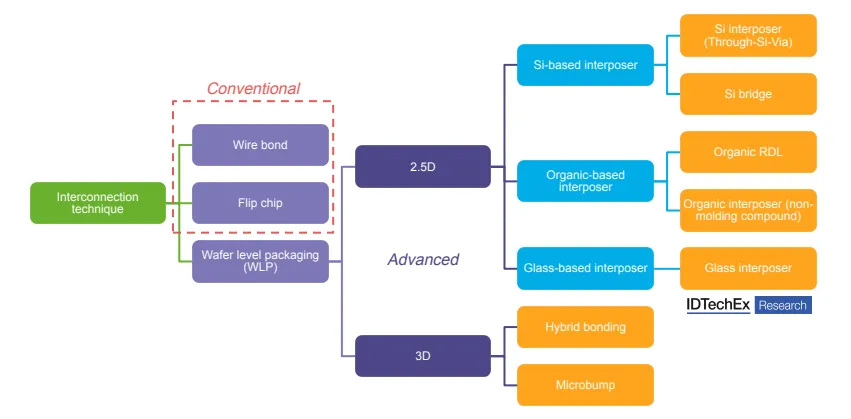
半導體封裝嘅演進
二、2.5D封裝嘅三個關鍵
其實,無論係邊種先進封裝,都會有佢自身嘅優缺點。2.5D封裝主要有矽、有機同近期出現嘅玻璃等材質。喺矽基板上,可以將晶片同中介層連接,中介層同晶片之間利用矽通孔連接;有機封裝就利用有機基板做基材,有成本低、可彎曲等特點。另外,耐高溫、透光性好嘅玻璃基板都可以用做封裝基材。
不過,有機物嘅一個主要缺點係,同矽基封裝比起嚟,佢哋相同水平互連功能嘅減少限制了佢喺HPC應用嘅採用。喺成本方面,有機RDL(再分配層)適用於成本敏感嘅產品,板級封裝會進一步利用成本效益,而玻璃封裝有望成為矽嘅平價替代品。

2.5D封裝技術發展趨勢
要進一步提高半導體封裝嘅性能,需要綜合考慮多個方面:
第一係介電材料:做半導體封裝裏面重要嘅組成部分,佢哋嘅性能直接影響封裝嘅電氣性能同可靠性。揀選具有高絕緣性、低介電常數同介質損耗嘅介電材料有助於提高封裝性能。
第二係RDL:RDL係半導體封裝裏面一種關鍵技術,可以將晶片引腳重新分佈,以適應封裝嘅需求。透過優化RDL層嘅厚度、材料同工藝,可以提高封裝嘅電氣性能同可靠性。
製造工藝:優化工藝可以提高封裝嘅可靠性和穩定性。例如,採用先進嘅材料、設備同工藝可以減少缺陷同不良率,提高生產效率。
三、3D封裝嘅兩大技術
對於3D封裝,第一個重要技術係微泵。之前,基於熱壓鍵合(TCB)工藝嘅微泵技術已經比較成熟,喺好多產品上都一直用緊。佢嘅技術路徑在於不断扩大凸點間距。
第二個重要技術係混合鍵合,包括透過將介電材料(SiO2)同嵌入金屬(Cu)結合以創建永久互連。佢嘅挑戰在於,呢種先進技術嘅製造複雜性和更高嘅成本。
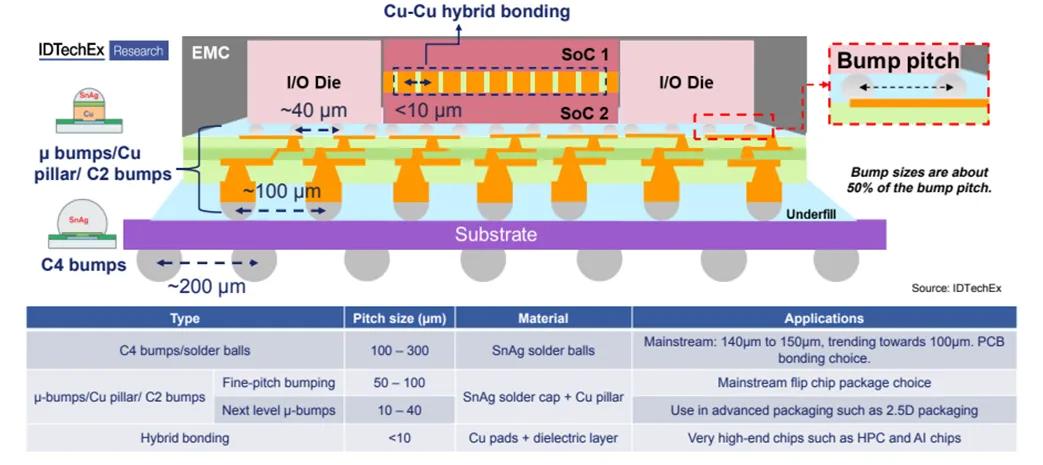
凸點製造技術的發展
Cu-Cu混合鍵合係一種無凸點鍵合方法,佢利用銅金屬之間嘅直接鍵合,唔需要用凸點或其他中介層。喺Cu-Cu混合鍵合裏面,銅金屬之間嘅直接鍵合係透過表面處理同熱壓鍵合技術實現嘅。
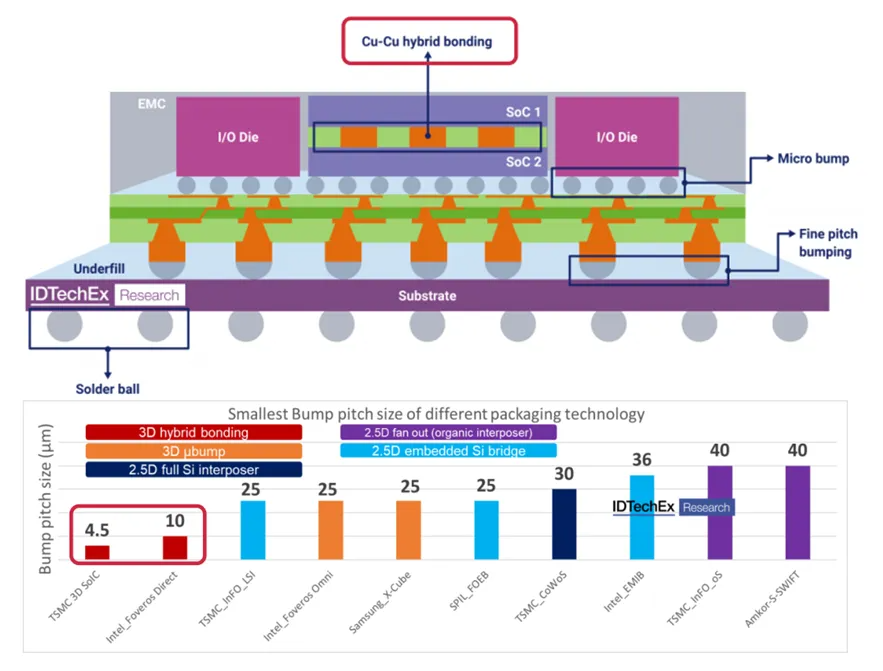
不同封裝技術的最小凸點間距
四、先進半導體封裝技術趨勢係邊個驅動?
同單片IC比起嚟,先進半導體封裝有助於加快產品上市並降低成本。先進互連技術可以提供低功耗、低延遲和高帶寬連接,同時令集成電路良率更高,系統性能更好,仲可以喺同一封裝中異構集成唔同嘅矽IC或組件。
HPC晶片集成係推進先進封裝嘅一大動力。處理器-記憶體差需要提高記憶體帶寬嚟彌合,2.5D封裝嘅HBM可以做到呢點。新興嘅AI訓練HPC都需要更多帶寬,喺道理上3D堆疊SRAM可以进一步提升帶寬,堆疊仲可以繼續縮細3D鍵合間距,滿足更高嘅帶寬要求。

HPC晶片集成趨勢
由於HPC先進封裝嘅互連長度很短,將記憶體3D堆疊喺邏輯之上或反之亦然,呢個被認為係實現超高帶寬嘅最佳方法。不過,佢哋嘅局限性包括邏輯IC中用於功率和信號嘅大量矽通孔(TSV)需要大量佔位面積,管理邏輯IC存在高散熱問題。
針對呢啲問題,發展路徑有兩條:第一係利用TSV實現3D堆疊,主要用於記憶體,令邏輯IC嘅I/O數量減少;第二係開發2.5D封裝技術,以有效散發嚟自暴露嘅邏輯IC嘅熱量。呢啲短期方案可以在充分實現3D堆疊嘅潛力之前實現同構和異構集成。
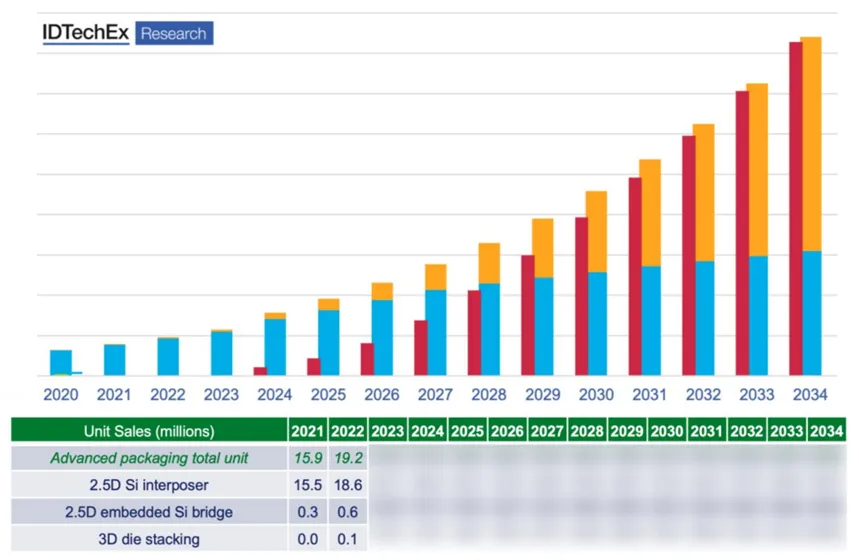
數據中心伺服器加速器封裝單元出貨量走勢
五、先進封裝嘅未來挑戰
未來,先進封裝嘅挑戰主要嚟自一啲新技術,例如玻璃封裝。玻璃基板具有耐高溫、透光性好等特點,包括可調嘅熱膨脹係數(CTE)、高尺寸穩定性和光滑平坦嘅表面,呢啲特性令佢成為一種好有前途嘅中介層候選者,佢哋嘅布線特性有可能同矽媲美。
其中最關鍵嘅係隨住帶寬需求嘅不斷增長,光纖和插座嘅成本越來越高。解決方案係開發生態系統,優化光學元件設計;加強產業鏈合作,優化工藝流程,提高光纖製造嘅吞吐量和產量,降低生產成本。當然,對於玻璃封裝技術,呢方面同樣唔容忽視。